光刻
出处:按学科分类—工业技术 北京工业大学出版社《特种加工手册》第611页(1809字)
9.4.3.1 加工原理
光刻加工原理与照相制版差不多.它是利用光致防蚀剂的光化学反应特性,将掩膜板上的图形精确地印制在涂有光致防蚀剂的衬底表面上,再利用光致防蚀剂的耐腐蚀性,对衬底表面进行腐蚀,从而可获得复杂的精细图形.
光刻精度很高,其尺寸精度可达到0.01~0.005mm,是半导体器件和集成电路制造中的关键工艺之一,对大规模集成电路的制造,起了推动作用.
根据光刻原理,可以制造一些精密产品的零部件.如刻线尺、刻度盘、光栅、细孔金属网板、电路布线板以及可控硅元件等,在电子、光学和精密机械等领域中均有作用.
9.4.3.2 工艺过程
光刻主要工艺过程如下:
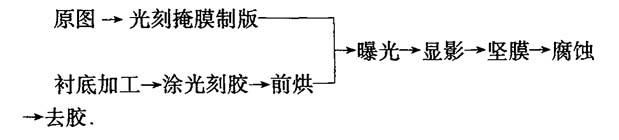
图9-28为半导体光刻工艺过程示意图.

图9-28 半导体光刻工艺过程示意图
1—衬底(硅);2—光刻薄膜(SiO2);3—光防蚀层;4—掩模版
(1)原图和掩膜版 先在透明或半透明的聚脂基板上涂覆一层醋酸乙烯树脂系的红色可剥性薄膜,然后把所需的图形按比例放大几倍至几百倍,用绘图机刻制在可剥性薄膜上,把不需要的薄膜剥除,即制成原图.掩膜板起样板作用,其制备方法是:先利用初缩照相机把原图缩小制成初缩版,然后采用分步重复照相机将初缩版精缩,使图形进一步缩校从而获得尺寸精确的照相底版.再把照相底版用接触复印法,将图形印制到高纯度铬金属版(铬金属版是用表面经过磨光的玻璃板,上面蒸涂一层厚度为150~200nm的高纯度铬,其表面再涂光刻胶制成的)上,经过腐蚀,即获得金属薄膜图形的掩膜版.
(2)涂覆光致防蚀剂 光致防蚀剂是光刻工艺的基矗它是一种对光敏感的高分子溶液,故又称光敏防蚀剂.根据它的光化学反应特性,可分为正性和负性两种.如果工件表面上的光致防蚀剂经过曝光后可溶解,则称为正性光致防蚀剂(或正像加工),即可获得和掩膜版相同的抗蚀涂层.反之则称为负性光致防蚀剂.见图9-29.
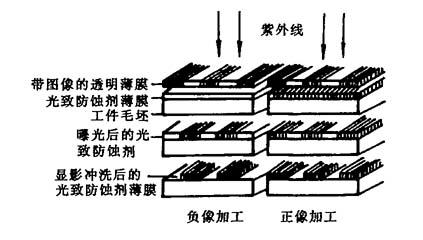
图9-29 光致防蚀剂的工作原理
在半导体工业中常用的光致抗蚀剂有:聚乙烯醇-肉桂酸脂系(负性)双迭氮系(负性)和醌-二迭氮系(正性)等.
(3)曝光 曝光光源的波长应与光刻感光范圈相适应,一般用波长为0.4μm的紫外光.常用曝光方式是接触式曝光,即将掩膜版为涂有光致抗蚀剂的衬底表面紧密接触进行曝光.
随电子工业的发展,对精度要求更高的精细图形进行光刻时,其最细的线条宽度要求在1μm以下,紫外光已不能满足此要求,需采用X线曝光等新技术,电子束曝光可刻出宽度为0.25μm的细线条.
(5)腐蚀 不同的光刻材料,选用不同的腐蚀液.腐蚀方法有:化学腐蚀、电解腐蚀、离子腐蚀等.其中常用的是化学腐蚀,即采用化学溶液对带有光致抗蚀剂层的衬底表面进行腐蚀.常用的化学腐蚀液见表9-8.
表9-8 常用光刻化学腐蚀液

(6)去胶 腐蚀后,衬底表面还残存一些抗蚀剂胶膜,可采用强氧化剂(如硫酸-过氧化氢混合液等)将胶膜破坏除去,也可采用丙酮、甲苯等有机溶剂去胶.此外,将带胶衬底置于氧气压为10Pa的真空中,在高频电磁场的作用下,令氧电离,并与光刻胶反应变成挥发性气体排出.此法具有表面干净,不污染环境的特点.